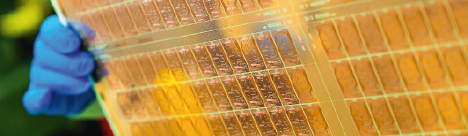 AI- och serverkretsar blir allt större och effekthungrigare för varje ny generation. För att kapslingen inte ska stoppa utvecklingen planerar Intel att mot slutet av detta decennium byta dagens substrat av epoxi och glasfiber till glas.
AI- och serverkretsar blir allt större och effekthungrigare för varje ny generation. För att kapslingen inte ska stoppa utvecklingen planerar Intel att mot slutet av detta decennium byta dagens substrat av epoxi och glasfiber till glas.
Glas är formstabilare och sätare än substrat av epoxi och glasfiberväv plus att fördelarna ökar ju större och ju fler kiselbitar det sitter i kapseln. Att därför byta kärnan i kapslarnas mönsterkort till glas är ett naturligt steg även om det fortfarande återstår en hel del arbete innan tekniken kan lämna utvecklingslabbet.
– Vi har satt ihop en komplett testkrets med ett glassubstrat och två chip som fungerar, säger Rahul Manepalli på Intel.
Den har tillverkats i företagets pilotlina i Chandler, Arizona, där Intel har ett utvecklingscenter för avancerad kapsling liksom en fabrik för 2D- och 3D-byggsätt, Emib och Foveros, som använts kommersiellt sedan 2017 respektive 2019.
Intel har satsat över en miljard dollar under tio års tid på utvecklingen av glassubstrat tillsammans med olika leverantörer av maskiner och material. Företaget verkar nu känna sig tillräckligt säkert på att allt kommer att fungera, för att lätta lite på förlåten.
Fördelarna med glassubstrat är lätta att förstå. En glasyta är mycket planare än ett mönsterkort av glasfiberväv och epoxi vilket gör att man kan skapa tunnare ledare med kortare avstånd mellan dem men också dra ledare genom glaset. Testkretsen har tre ledarlager på vardera sidan av glassubstratet som är 1 mm tjockt.
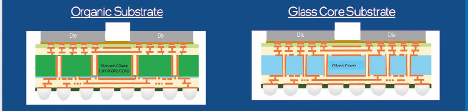 |
| Kärnan i dagens kapslingssubstrat består av glasfiberväv och epoxi (det gröna i vänstra bilden), Intel vill byta ut det mot glas (det blåa i högra bilden). |
Genom att designa glaset med rätt sammansättning går det också att sänka förlusterna hos signalerna jämfört med glasfiber och epoxi.
Dessutom ligger värmeutvidgningskoefficienten närmare kislets vilket minskar risken att temperaturcykling får chipen att lossna.
Det här är goda nyheter för extremt stora och effekthungriga kretsar till servrar och för AI-beräkningar, som redan idag ligger på gränsen för vad som går att göra med organiska laminat. Dessutom blir det enklare att ha flera chip i samma kapsel, exempelvis ett AI-chip och ett minne.
Intel räknar med att ledarna i en framtida kommersiell process kan göras med en bredd under 5 µm och med avstånd på 5 µm. Förbättringen kommer sig av den slätare ytan som gör att mönstret som projiceras under tillverkningsprocessen får skarpare konturer. Avståndet mellan två viahål genom substratet kan vara mindre än 100 µm.
För själva chipen räknar Intel med att de kan ha lödkulor med ett avstånd som är mindre än 36 µm när det bara finns ett chip i kapseln, så kallad D2D (die-to-die) medan det i kapslar med flera chip är under 80 µm som gäller för lödkulorna, även kallat core bump pitch.
Glas gör det också möjligt att öka storleken på chipen, Intel räknar med så mycket som 50 procent extra eller kapslar så stora som 240×240 mm.
Glasets släta yta i kombination med de dielektriska egenskaperna ger lägre signalförluster vilket innebär att det blir möjligt att hantera datatakter upp till 448 Gbit/s utan att gå över till fiberopisk kommunikation.
 Artikeln är tidigare publicerad i magasinet Elektroniktidningen. Artikeln är tidigare publicerad i magasinet Elektroniktidningen.Prenumerera kostnadsfritt! |
Det blir också enklare att tillverka kondensatorer och induktanser på substratet eftersom glas tål de högre temperaturer som behövs för tillverkningsprocessen till skillnad från organiska material, som kan skadas.
Hur långt fram den kommersiella lanseringen ligger är oklart, Intel nöjer sig med formuleringen ”andra halvan av detta årtionde”.